弊社では、イオンプレーティング方式に加えスパッタ法によるコーティングサービスも始めました。
スパッタ法での高エネルギーを利用してTi系反応膜の形成を行っております。
現在スパッタ法での対応膜種は、Ti、TiN、TiCの3膜種とさせていただいております。
またチャンバー(真空窯)内の異種異物による汚染防止のため、基板(膜付け対象物)の材質を限らせていただいております。一度ご相談下さい。
当社のスパッタリング法における基本プロセスを右図に記します。
簡単にご説明いたしますと、プロセスは以下の通りです。
- チャンバーに膜付け対象物をセット
- チャンバー内を真空排気
- ランプヒーターによる基板加熱
無加熱も可能です。一度ご相談下さい。 - ガスを導入する
反応膜の場合は反応ガスも後に導入 - ターゲット源をON
- Arガスによりターゲット材料がスパッタされる
- スパッタされた粒子が基板に到達して堆積
- 薄膜形成される
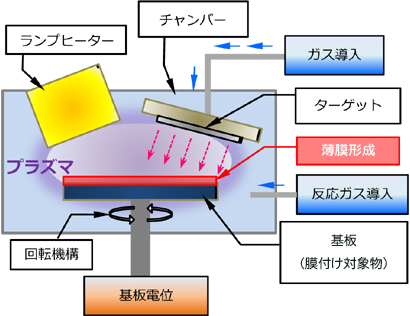
| 最大搭載可能サイズ | φ12インチ×t50mm |
|---|---|
| 対応可能基板 | Si Wafer,各種ガラス基板 Al系基板(Al2O3,AlN) Si系基板(SiC等) |
| 対応不可基板 | SUS系、他金属混合物系 |
※大変申し訳ございませんが、半導体基板対応とするため膜付けするチャンバー内の汚染を考慮して、搭載する基板に制限をさせていただいております。お手数をおかけ致しますが、ご対応可能かお問い合わせ下さい。
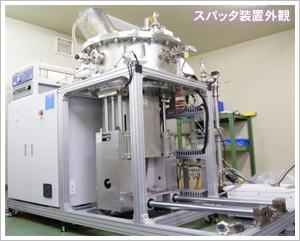
スパッタリングにて形成した薄膜の性能評価事例です。イオンプレーティングにて形成した膜との比較も掲載してあります。ご参考にして下さい。
| 評価項目 | Ti | TiN | TiC |
|---|---|---|---|
| 可能膜厚 | 0.05~5.0 μm | 0.05~5.0 μm | 0.05~5.0 μm |
| 密着強度 | ピールテストで剥れ無き事 | ピールテストで剥れ無き事 | ピールテストで剥れ無き事 |
膜応力比較データ(膜種:TiC / 膜厚6μmで計測)
| 成膜位置 | 実測値 | 戻り値 | 膜応力 |
|---|---|---|---|
| イオンプレーティング |  | 246.5μm | 1.42E+08Pa |
| スパッタリング |  | 91.138μm | -5.69E+07Pa |
[膜応力比較]
イオンプレーティング法では引っ張り応力が生じています。これに対してスパッタ法では圧縮応力が生じています。この差は膜に成長したときに残る在留応力によるものです。この応力も条件によって緩和したり、逆方向の応力とすることもできます。
摩擦係数比較データ(膜種:TiC / 膜厚6μmで計測)
| 成膜位置 | 実測値 | 初期摩擦係数(μs) | 動摩擦係数(μk) |
|---|---|---|---|
| イオンプレーティング |  | 0.265 | 0.213 |
| スパッタリング |  | 0.198 | 0.151 |
[摩擦係数比較]
イオンプレーティング法でに比べ、スパッタ法での膜のほうが静止摩擦係数、動摩擦係数ともに低くなっているのが確認できます。膜付け条件が全く同じではありませんが、成膜方法や条件により変化します。
比抵抗比較データ(膜種:TiC / 膜厚6μmで計測)
| 成膜方法 | 比抵抗 |
|---|---|
| イオンプレーティング | 1.07E-05Ω・cm |
| スパッタリング | 1.37E-05Ω・cm |
[比抵抗]
上記特性が異なるのに対し、比抵抗はほぼ同じ値となります。膜厚が厚いこともありその影響は小さくなっています。





